今天主要以安靠技術(shù)(Amkor Technology)于2021年發(fā)表的一篇關(guān)于高密度超薄interposer Package on Package的研究論文《Chip-Last HDFO (High-Density Fan-Out) Interposer-PoP》為基礎(chǔ)�����,聊聊中介層Package on Package技術(shù)發(fā)展趨勢�。備注:安靠是全球前三的封測代工企業(yè)。
先看看名字“Chip-Last HDFO (High-Density Fan-Out) Interposer-PoP” 分為幾個關(guān)鍵詞:Chip-Last, HDFO(High-Density Fan-Out), Interposer, POP��。接下來我們一一對其進(jìn)行簡述����。
Chip-Last: 很簡單有chip-last 就應(yīng)該有chip-first����。如圖1所示,chip first 是指先制備好芯粒將其放于不同形式的Carrier 上��,然后制備RDL層最后貼焊錫球��。而Chip last 是先將RDL制備好�����,然后貼裝芯粒,塑封最后再貼焊錫球�。

HDFO(High-Density Fan-Out)高密度扇出,這個概念對應(yīng)的就有Fan-In�。兩者最大的差異為RDL布線,在扇入型封裝中����,RDL向內(nèi)布線,而在扇出型封裝中����,RDL既可向內(nèi)又可向外布線,所以扇出型封裝可以實(shí)現(xiàn)更多的I/O����。

圖2 Fan in,F(xiàn)an out 封裝差別
Interposer在我們艾邦半導(dǎo)體公眾號里已經(jīng)有多篇介紹���。中介層利用硅通孔技術(shù)TSV���,最終起到鏈接芯粒與Substrate的作用。
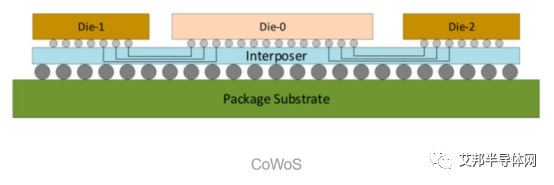
POP (Package on Package)是指疊層封裝技術(shù)�,通常應(yīng)用在手機(jī)及筆記本電腦等領(lǐng)域�����,通過將邏輯芯片及存儲芯片等不同芯片疊層封裝從而實(shí)現(xiàn)超薄�、低功耗�����、低信號損失的目的��。在POP工藝中核心難點(diǎn)在于控制產(chǎn)品室溫到260°的翹曲變形���。

如圖5所示�,POP要不斷的變薄還分兩條技術(shù)路線:層壓基板POP和RDL(重布線)POP���。層壓基板由于本身工藝很難再繼續(xù)減薄�,而RDL有著巨大的空間���。

從圖6和圖7可以直接對比出RDL Layer于普通層壓基板的厚度差異。上下都采用RDL層的產(chǎn)品厚度僅為400微米���,而采用層壓基板的同類產(chǎn)品厚度為450微米���。通過使用RDL層可以減少近50微米�。

圖6 (a) interposer-PoP 上下層都為RDL
(b) interposer-PoP 下層為RDL上層為層壓式substrate
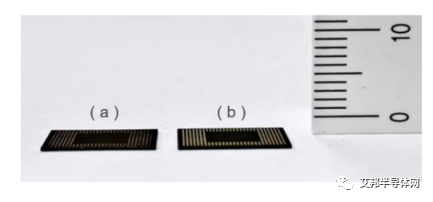
圖7 (a) interposer-PoP 下層為RDL上層為層壓式substrate �����;(b) interposer-PoP 上下層都為RDL
接著再對比一下兩種產(chǎn)品動態(tài)翹曲的差異���,兩者翹曲差異不大����,上下兩層皆為RDL的翹起要略高于RLD+層壓基板����。當(dāng)然還可以通過后續(xù)的RDL層設(shè)計優(yōu)化進(jìn)一步減少翹曲。

圖8 左圖為上下兩層RDL的POP產(chǎn)品動態(tài)翹曲曲線
右圖為RDL+層壓基板POP產(chǎn)品動態(tài)翹曲曲線
最后���,由于RDL具備超薄����,良好的電性能��,制備精度高等優(yōu)點(diǎn)��,隨著業(yè)界對RDL層研發(fā)設(shè)備及工藝的不斷投入,RDL技術(shù)在未來將會逐步進(jìn)入越來越多的應(yīng)用領(lǐng)域��。當(dāng)然還有一個更利于我國的優(yōu)勢�,RDL的制程當(dāng)前國內(nèi)設(shè)備基本可以滿足,沒有卡脖子問題��。相信我國RDL相關(guān)領(lǐng)域?qū)伙w猛進(jìn)�。
Chip-Last HDFO (High-Density Fan-Out) Interposer-PoP,Amkor Technology
原文始發(fā)于微信公眾號(艾邦半導(dǎo)體網(wǎng)):先進(jìn)封裝之高密度超薄疊層封裝(POP)介紹